

个人信息
Personal Information
联系方式
Contact Information
个人简介
Personal Profile
山东菏泽人
2019年 美国弗吉尼亚理工大学(CPES)和天津大学联合培养博士毕业(导师Guo-Quan Lu教授)
2021年“人才引进”入职南开大学
在IEEE Transactions on Power Electronics等顶刊发表高水平论文50余篇,其中第一或通讯作者论文30余篇;
主持科研项目10余项,经费700余万元;参与项目经费2000余万元;
出版著作1部;
申请发明专利10余项,授权6项;
在学会、期刊、会议等获奖5项;
获得了丰硕的科研成果,在电子封装领域具有一定的知名度和影响力。
详细信息参见:https://ceo.nankai.edu.cn/szll/wndzxx/wmy.htm
上传附件
支持扩展名:.rar .zip .doc .docx .pdf .jpg .png .jpeg上传附件
支持扩展名:.rar .zip .doc .docx .pdf .jpg .png .jpeg上传附件
支持扩展名:.rar .zip .doc .docx .pdf .jpg .png .jpeg参与项目经费>2000万,主持项目经费>700万
1、 国家自然科学基金-青年项目:无压低温烧结多尺度银-镍界面互连封装SiC器件的研究(主持)
2、 广东省自然科学基金-面上项目:多尺度铜互连封装SiC功率模块的材料、工艺及可靠性研究(主持)
3、 中央高校专项基金项目:芯片3D封装的低应力设计(主持)
4、 科技部“863计划”项目:第三代半导体器件高密度封装工艺与关键材料,1816万(参与)
5、 华为-技术合作开发项目:万伏千安级SiC功率模块光电共封技术(主持)
6、 镓未来-技术合作开发项目:GaN功率器件及应用系统温度和应力仿真分析(主持)
7、 苏州恒悦-技术合作开发项目:烧结铜互连材料与工艺(主持)
8、 凯锶-技术合作开发项目:烧结铜浆料工艺技术(主持)
9、 科利金-技术合作开发项目:用于芯片湿贴工艺的低温有压烧结银材料开发(主持)
10、光本位-技术合作开发项目:前端发射链路预研和BGA封装(主持)
11、创新科-技术合作开发项目:芯片封装技术研发(主持)
12、创新科-技术合作开发项目:可重构边缘信息收集芯片及数据实时处理系统研发(主持)
[1] Meiyu Wang, et al. Bonding and Failure Mechanisms of Sintered-silverDie-attach on Electroless Nickel (Phosphorus) Surface Finish for PackagingPower Electronics Modules. IEEE Transactions onPower Electronics, 2024. (中科院一区,第一作者)
[2] Meiyu Wang, et al. Pressureless Sintered-silver Die-attach at 180°C for PowerElectronics Packaging. IEEE Transactions on Power Electronics,2021, 36(11): 12141-12145. (中科院一区,第一作者)
[3] Meiyu Wang, et al. Pressureless Silver Sintering on Nickel for Power ModulePackaging. IEEE Transactions on Power Electronics,2019, 34(8): 7121-7125. (中科院一区,第一作者)
[4] Meiyu Wang, et al. Characterization of Multiple Commercial Sintered-silverPastes as Die-attach for Power Electronics Packaging: Materials, Processing,and Properties. IEEE Journal of Emerging and SelectedTopics in Power Electronics, 2024. (中科院一区,第一作者)
[5] Meiyu Wang, et al. Pressureless Sintered-silver as Die Attachment for BondingSi and SiC Chips on Silver, Gold, Copper, and Nickel Metallization for PowerElectronics Packaging: The Practice and Science. IEEEJournal of Emerging and Selected Topics in Power Electronics, 2022, 10(2): 2645-2655. (中科院一区,第一作者)
[6] Meiyu Wang, et al. Reliability Improvement of A Double-sided IGBT Module byLowering Stress Gradient Using Molybdenum Buffers. IEEE Journal of Emergingand Selected Topics in Power Electronics, 2019, 7(3): 1637-1648. (中科院一区,第一作者)
[7] Wenbin Deng, Yunhui Mei*, MeiyuWang*, et al. A Way to Reduce Leakage Current and Improve Reliabilityof Wire-Bonds for 300-A Multi-Chip SiC Hybrid Modules. IEEE Journal ofEmerging and Selected Topics in Power Electronics, 2020, 9(4):4887-4896. (中科院一区,共同通讯作者)
[8] Meiyu Wang, et al. Advanced Packaging Technology of GaN HEMTs Module forHigh-power and High-frequency Applications: A Review. IEEE Transactions onComponents Packaging and Manufacturing Technology, 2024, 14(9): 1537-1550. (中科院三区,第一作者)
[9] Meiyu Wang, et al. Electrical Method to Measure the Transient ThermalImpedance of Insulated Gate Bipolar Transistor Module. IET Power Electronics,2015, 8(6):1009-1016. (中科院二区,第一作者)
[10] Yunhui Mei, Baisen Hao, Yue Chen, Meiyu Wang *, et al. Efficient Layout Design Automation forMulti-Chip SiC Modules Targeting Small Footprint and Low Parasitic. IETPower Electronics, 2020, 13(10): 2069-2076. (中科院三区,通讯作者)
[11] Meiyu Wang, et al. How to Determine Surface Roughness ofCopper Substrate for Robust Pressureless Sintered Silver in Air. MaterialsLetters, 2018, 228: 327-330. (中科院二区,第一作者)
[12] Weibo Hu, Mingyi Xue, Xiang Yan,Jiarui Ren, Kefan Qin, Wei Ma, Guangshu Zhao, Zhiming Xiao, Meiyu Wang*. A SARADC for Multichannel Synchronous Signal Acquisition, MicroelectronicsJournal, 2023, 141, 105980. (中科院三区,通讯作者)
[13] Kefan Qin, Weibo Hu, Xiang Yan,Shangzheng Yang, Haitao Cui, Meiyu Wang*. A Hybrid SAR ADC with Input Range Extension, MicroelectronicsJournal, 2024, 150, 106259. (中科院三区,通讯作者)
[14] Meiyu Wang, et al. Die-attach on Nickel Substrate by PressurelessSintering A Trimodal Silver Paste. Materials Letters, 2019,253: 131-135. (中科院三区,第一作者)
[15] Xinyin Zhang, Meiyu Wang,et al. A Method for Improving the Thermal Shock Fatigue Failure Resistance ofIGBT Modules. IEEE Transactions on Power Electronics, 2020, 35(8):8532-8539. (中科院一区)
[1] “ICEP-2018 IEEE OutstandingTechnical Paper Award,2018
[2] ICEP-2015 IEEE CPMT Japan Chapter Young Award,2015
[3] 《电源学报》2023年度优秀论文,2023
[4] 中国电工技术学会科学技术奖(技术发明奖)一等奖:面向高功率密度应用的高温可靠、大容量 SiC 器件关键技术,2020
[5] 中国电源学会科学技术奖(技术发明奖)一等奖:车用高密度功率模块封装关键技术、材料与应用,2019
[6] 《电子与封装》优秀审稿专家,2024
课题组具备完整的材料制备、工艺方法、性能测试和可靠性验证登仪器,包括不限于:进口精密控温加热台,自主研发加压烧结炉、进口ATV真空共晶回流炉、高速搅拌机、进口Dage4000推拉力测试仪、全自动超声波引线键合机、自主研发热阻测试仪、自主研发双脉冲测试仪、电导率测试仪、高温干燥箱、高速离心机、进口Tektronix示波器、进口Keysight精密电源、30kV高压源、丝网印刷机、温度循环可靠性测试等。
同时可共享电子信息与光学工程学院和南开大学大型仪器平台设备,实验条件完善。
课题组部分仪器列表如下:

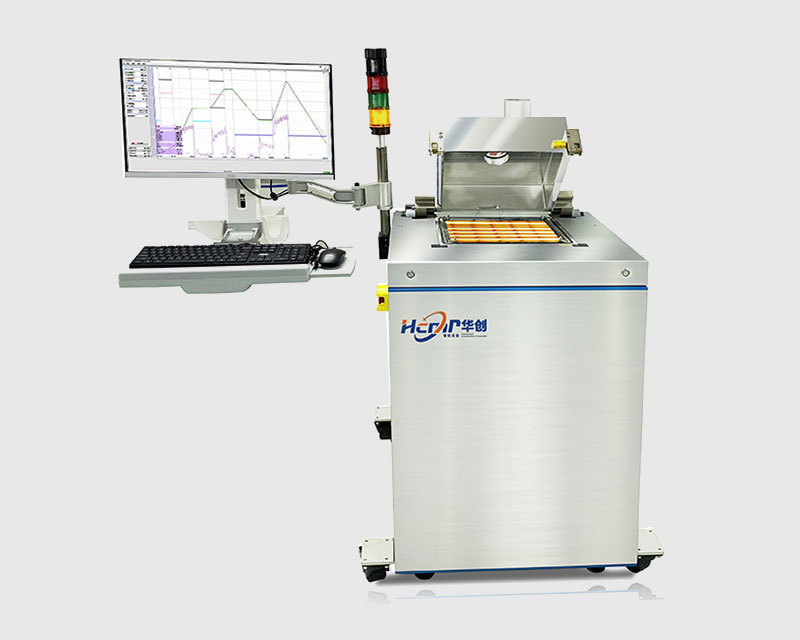







[1] Electronics、Mciromachines等期刊的 Guest Editor
[2] 国家自然科学基金项目评审专家
[3] IEEE Transactions on Power Electronics等多个期刊审稿人
[4] IEEE Member, 中国电工技术学会会员、中国电源学会会员
于洪宇,王美玉,谭飞虎. 低温共烧陶瓷系统级封装(LTCC-SiP):5G 时代的机遇,科学出版社,2025年3月

文件上传中...